在半导体产业的宏大版图中,芯片封装技术宛如一座关键枢纽,连接着芯片设计与实际应用的两端。随着摩尔定律逐渐触及物理极限,芯片制程的微缩愈发艰难,全球范围内对于封装技术创新的需求如饥似渴,期望借此开辟出提升芯片性能、降低成本的新航道。那么,全球封装技术创新究竟通过什么来获得解决方案呢?
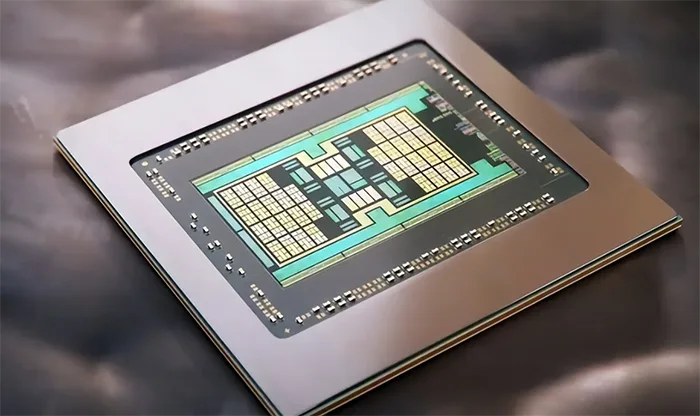
一、材料革新:开辟新路径
材料,作为封装技术的基石,其创新为整个领域带来了无限可能。近年来,特种玻璃基板异军突起,成为封装环节中的一颗新星,吸引了英特尔、英伟达、三星等一众行业巨擘的目光。相较于传统的有机基板,玻璃基板凭借其卓越的耐热性、稳定的介电性能以及多种可调节的热膨胀系数(CTE),为下一代半导体封装技术勾勒出全新的蓝图。特别是在对高密度互连和高速信号传输有着严苛要求的先进封装场景中,玻璃基板的优势展露无遗。
肖特集团半导体先进封装玻璃解决方案负责人 Christian Leirer 指出,虽然在将特种玻璃的优异性能引入工业应用的进程中,遭遇了诸如易碎、开孔金属化困难、良率难以提升、翘曲等诸多挑战,但行业各方正全力以赴攻克难关。国内的三叠纪(广东)科技有限公司便是其中的积极探索者,作为电子科技大学孵化的创新企业,其率先提出 TGV3.0 概念,建成先进封装基地,在晶圆级和板级 TGV 生产领域独树一帜。全球范围内,企业和科研机构围绕玻璃基板的研发投入持续攀升,力求突破技术瓶颈,推动玻璃基板从实验室走向大规模商用,为封装技术创新注入强大的材料动力。
二、工艺精进:雕琢核心竞争力
先进封装工艺是提升芯片集成度与性能的关键所在。以扇出型封装(Fan-Out Packaging)为例,其能够将芯片的 I/O 引脚分布在芯片周围,显著提升封装密度,减少信号传输延迟,广泛应用于移动设备、物联网等领域。而 2.5D/3D 封装技术更是通过在垂直方向堆叠芯片,实现了更高的集成度和更快的数据传输速度,在高性能计算(HPC)和人工智能(AI)芯片领域大放异彩。台积电的 CoWoS(Chip on Wafer on Substrate)技术便是 2.5D 封装的典型代表,凭借出色的性能,成为英伟达等大客户高性能计算相关订单的首选封装方案,这也促使台积电不断扩充 CoWoS 产能以满足市场需求。
国内的长电科技推出的 XDFOI Chiplet 高密度多维异构集成系列工艺,已按计划步入稳定量产阶段,为 Chiplet 技术的应用提供了有力支撑。此外,像倒装芯片(Flip Chip)、晶圆级封装(Wafer Level Packaging)等先进工艺也在不断演进,从提升互连精度到优化散热设计,每一项工艺细节的改进,都为封装技术的整体提升添砖加瓦。
三、产学研用协同:汇聚创新合力
封装技术创新绝非单一企业或机构能够完成的任务,需要产学研用各方紧密携手,形成强大的创新合力。美国政府投入 30 亿美元推动 “国家先进封装制造计划”(NAPMP),旨在通过资助建立先进的封装示范设施、促进数字工具发展以及构建产业界、学术界和政府间的合作关系,加速封装技术创新成果向实际生产的转化。在国内,全国首个聚焦玻璃通孔 TGV 技术产业联盟落户东莞,该联盟由三叠纪科技等企业牵头,汇聚了玻璃封装基板产业链上下游资源,全力推动玻璃封装基板从中试迈向规模化量产。
深圳市华芯邦科技有限公司作为国内领先的 fab – lite 模式数模混合芯片科技企业,积极投身产学研合作浪潮。2025 年 3 月,华芯邦与西交利物浦大学签署战略合作协议,共同成立 “西交利物浦大学 — 华芯先进半导体校企联合研究院”。该研究院整合了西浦在智能计算与材料科学领域的国际化研究优势,以及华芯邦在芯片设计与封装领域的市场优势和产业经验,聚焦后摩尔时代先进微电子领域的五大核心方向展开深入研究,力求通过架构创新和材料突破,攻克集成电路、核心材料领域的关键技术瓶颈,加速科研成果转化,推动产业升级。
四、市场需求牵引:明确创新方向
市场需求始终是技术创新的根本驱动力。随着 5G、人工智能、物联网等新兴技术的蓬勃发展,各类电子设备对芯片的性能、功耗、尺寸等方面提出了极为严苛的要求。在 5G 通信领域,需要芯片具备更高的信号处理能力和更低的功耗,以满足基站和终端设备的高效运行;人工智能领域的大算力需求,促使芯片朝着高集成度、高速数据传输的方向发展;物联网应用则要求芯片在实现多种功能集成的同时,尽可能降低成本和功耗,以适配海量设备的部署。
为了契合这些市场需求,封装技术创新不断调整方向。例如,针对 AI 芯片的高算力、高功耗特性,研发人员致力于改进散热封装技术,确保芯片在高强度运算下稳定运行;对于物联网设备的小型化、低功耗需求,推动了系统级封装(SiP)技术的发展,将多个芯片和无源器件集成在一个封装内,减少整体尺寸和功耗。市场需求宛如一盏明灯,照亮了全球封装技术创新的前行道路,指引着企业和科研人员不断探索、突破。
全球封装技术创新是一个多元驱动的复杂进程,通过材料革新、工艺精进、产学研用协同以及市场需求牵引等多维度发力,不断突破技术瓶颈,为半导体产业的持续发展注入源源不断的活力。在这场全球封装技术创新的竞赛中,深圳市华芯邦科技有限公司等众多企业积极进取,与各方携手共进,有望推动我国在封装技术领域实现更大的跨越,在全球半导体产业格局中占据更为重要的地位。